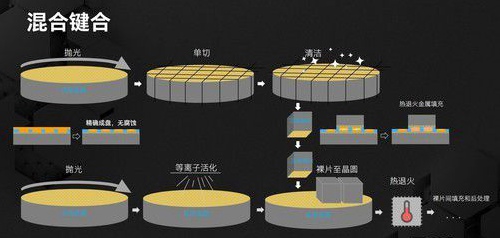
2月5日消息,据韩国媒体The Elec引述业界消息指出,为增强先进封装代工能力,三星开始导入混合键合(hybrid bonding)技术,预计用于下一代X-Cube、SAINT等先进封装。

近日,谷歌(Google)集成电路封装部门主管Milind Shah的最新研究也显示,在2012年的28nm工艺节点之后,晶体管的平均成本已经不再下降,这样直接导致了芯片的成本和价格居高不下。

当地时间1月24日,英特尔官方宣布,其位于美国新墨西哥州里奥兰乔(Rio Rancho)的尖端封装工厂 Fab 9 正式开业。这一里程碑是英特尔此前宣布的 35 亿美元投资的一部分,旨在升级其新墨西哥工厂,以制造先进的半导体封装技术,其中包括英特尔突破性的 3D 封装技术 Foveros,该技术为组合针对功耗、性能进行优化的多个芯片提供了灵活的选择和成本。

1月18日消息,据台媒报道,近期业界有传闻称,台积电今年将上修SoIC(系统整合单芯片)产能规划,今年底月产能将从2023年底的约2,000片,跳增至5,000~6,000片,以满足未来AI、HPC的强劲需求。

半导体封测大厂日月光投控于12月25日下午发布公告称,子公司日月光半导体已承租中国台湾福雷电子高雄楠梓厂房,目的主要是集团内厂房空间整体规划及有效运用,并扩充日月光封装产能。

12月19日消息,据路透社报道,越来越多的中国半导体设计企业正在通过与马来西亚公司合作,在当地进行部分高阶芯片的封装,其中包括GPU的封装工作,以避免美国扩大对中国半导体产业制裁的风险。不过,其中的制造环节只是封装,不牵涉芯片与晶圆的生产制造。

12月11日消息,近日业界传闻显示,三星将加入提供HBM3产能,使得先进封装所需高带宽内存供给增加,加上台积电通过更改设备与部分委外以拉高先进封装产能,以及部分云端服务供应商(CSP)变更设计与调整订单等三大因素带动下,先进封装产能瓶颈有望提前在明年一季度缓解,比业界预期提早一个季度至半年。

12月7日消息,市场研究机构IDC最新发布的研究报告称,随着全球AI、高性能计算(HPC)需求爆发式增加,加上智能手机、个人电脑、服务器、汽车等市场需求回暖,2024年全球半导体市场销售有望重回增长趋势,相比今年将大幅增长20%。
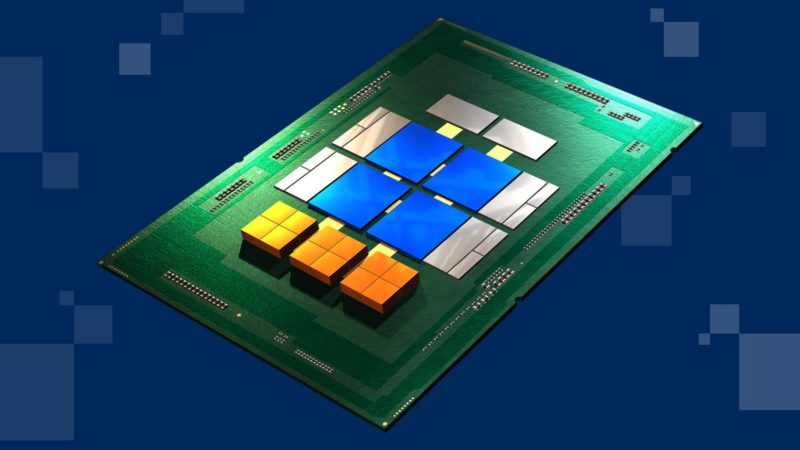
12月7日消息,据韩国媒体The Elec报导,三星在宣布推出全新的“SANIT”品牌的3D先进封装技术之后,近期已经订购了大量2.5D封装设备,希望大幅提升先进封装能力,以便与台积电竞争英伟达(NVIDIA)等AI芯片厂商的先进封装订单。

12月5日,中国台湾地区科学技术委员会发布公告,公布了以具主导优势与保护急迫性的技术为主的22项核心关键技术清单,涵盖了防务、农业、半导体、太空、信息安全等5大领域。