
5月19日,盛合晶微超高密度互联三维多芯片集成封装项目暨J2C厂房开工仪式在江阴高新区举行。

5月20日消息,据韩国 ZDNet援引的最新行业消息称,韩国存储芯片大厂三星和 SK 海力士正计划使用1c制程的DRAM来开发下一代的HBM4内存。

5月6日消息,据台媒《经济日报》报道,随着生成式AI需求持续爆发,也推动了英伟达(NVIDIA)、AMD等AI芯片巨头持续扩大供应,最新的传闻显示,台积电今年和明年的CoWoS与SoIC先进封装产能已经全部被包下。

4月29日消息,在上周的英特尔的财报会议上,英特尔CEO Pat Gelsinger表示,因晶圆级封装能力不足,使得二季度英特尔Core Ultra处理器的供应受到限制。

4月17日消息,据外媒naver报道,苹果公司正在台积电小量试产最新3D小芯片堆叠技术SoIC(系统整合芯片),最快有望2025~2026年有机会看到终端产品问世。
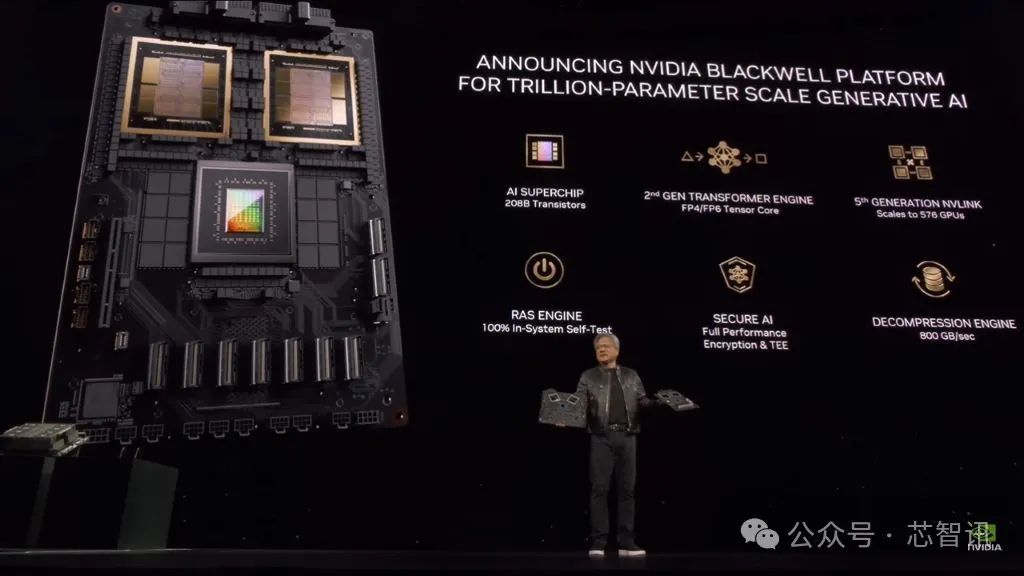
4月16日消息,英伟达(NVIDIA)最新推出的Blackwell平台产品包括了全新的B200 GPU及整合了Grace CPU的GB200等。市场研究机构TrendForce指出,GB200主要是替代上一代的GH200,但是GH200的出货量预计仅占上代英伟达高端GPU出货量约5%。目前供应链对GB200寄予厚望,预估2025年出货量有机会突破百万颗,将占英伟达高端GPU出货量的近40%~50%。

当地时间4月15日,美国商务部官网发布公告称,已与三星电子签署了一份不具约束力的初步条款备忘录(PMT),将根据《芯片和科学法案》向三星电子提供高达64亿美元的直接补贴资金,以加强美国半导体供应链的弹性,推进美国的技术领导地位,并增强美国的全球竞争力。同时,三星还还表示,计划申请美国财政部的投资税收抵免,预计将涵盖高达25%的合格资本支出。

4月8日消息,据韩国媒体TheElec报导,三星电子已经成功拿下了GPU大厂英伟达(NVIDIA)的2.5D封装订单。

4月6日消息,据《华尔街日报》报道,三星计划将大幅增加其在美国德克萨斯州泰勒市的半导体投资,预计将在计划的投资170亿美元建造一座5nm晶圆厂的基础上,再兴建一座新的先进制程晶圆厂、一座先进封装厂和一个研发中心,使得总体的投资金额达到约 440 亿美元 。

当地时间4月3日,存储芯片大厂SK海力士正式宣布,将投资38.7亿美元在美国印第安纳州西拉斐特(West Lafayette)建造适于AI的存储器的HBM(高带宽内存)的先进封装生产基地,预计将于2028年下半年开始量产。同时与美国普渡(Purdue)大学等当地研究机构进行半导体研究和开发合作。

3月18日消息,据台媒报道,传闻台积电将在嘉义科学园区扩产先进封装产能,政府将为其提供六座工厂的用地。