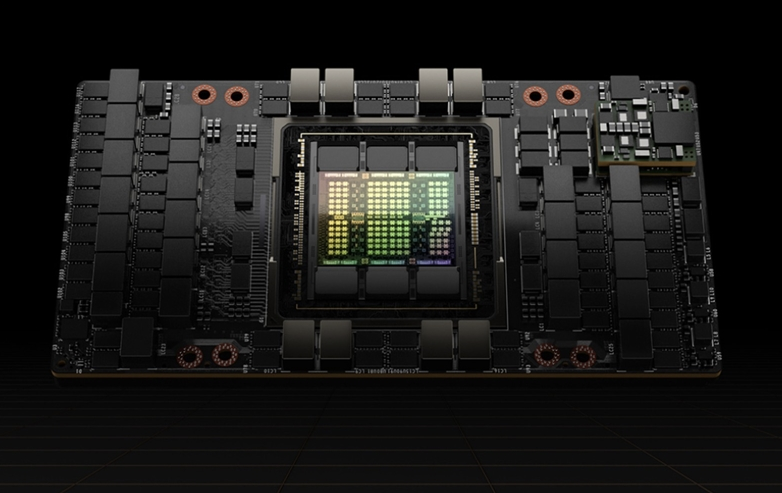
8月28日消息,据外媒报导,因为面向数据中心的AI芯片需求供不应求,英伟达计划提高2024年A100、H100 和其他 GPU加速卡的产量,以满足市场的强劲需求。知情人士透露,英伟达计划将H100加速卡(GH100芯片)的产能拉高至少三倍,预测明年的出货量将介于150~200万颗,远多于今年的50万颗。
当前,需要用到 GH100 芯片的产品,包括 H100 加速卡和 GH200 Grace Hopper (包括新版)等产品。而这些高阶产品想提高供应量并不是一件容易的事,这涉及到供应链的每一个环节,例如英伟达和台积电最近一段时间就为提高 CoWoS 封装产能而费尽心思。更何况 GH100 本来就是设计非常复杂的晶片,想大规模制造并不容易。
据了解,如果想大幅度提升 GH100 芯片产量,需要突破几个瓶颈。
首先,要保证 GH100 芯片的产量,英伟达需要台积电增加定制化 N4P 制程技术的产能。外媒粗略预估,目前每片 12 吋晶圆最多可以生产 65 颗 GH100 芯片。如果辉达想将产量提高到 200 万颗,那么需要约 3.1 万片晶圆,这条件对对于台积电当前月产能达 15 万片整个 5nm 制程技术的产能似乎没有太大问题。
其次,英伟达高端AI芯片依赖于台积电的 CoWoS 先进封装,但目前的产能是远远不则的,这也是为什么此前传出英伟达考虑让三星分担部分封装订单的原因之一。
据美系外资法人分析,英伟达是采用台积电 CoWoS 封装的最大客户,例如包括A100和H100系列均采用的是台积电CoWoS先进封装技术,英伟达占台积电 CoWoS 产能比重约 40% 至 50%。正因为CoWoS产能紧缺,英伟达 8 月上旬推出的 L40S 芯片,未采用 HBM内存,因此不会受制于台积电 CoWoS 封装产能不足的问题。
产业人士指出,通用图形处理器采用更高规格的高带宽内存,需借助由2.5D先进封装技术将核心晶粒(die)整合在一起,而 CoWoS 封装的前段芯片堆叠(Chip on Wafer)制程,主要在晶圆厂内透过 65nm制造并进行硅通孔蚀刻等工序,之后再进行堆叠芯片封装在载板上(Wafer on Substrate)。
不过台积电 CoWoS 封装产能吃紧,在 7 月下旬法人说明会,台积电预估 CoWoS 产能将扩增 1 倍,但供不应求情况要到明年底才可缓解。台积电 7 月下旬也宣布斥资近新台币 900 亿元,在竹科辖下铜锣科学园区设立先进封装晶圆厂,预计 2026 年底完成建厂,量产时间落在 2027 年第三季或第三季。
英伟达财务长克芮斯(Colette Kress)在 8 月 24 日在线上投资者会议透露,英伟达在 CoWoS 封装的关键制程,已开发并认证其他供应商产能,预期未来数季供应可逐步爬升,英伟达持续与供应商合作增加产能。
美系外资法人整合 AI 芯片制造的供应链信息指出,CoWoS 产能是 AI 芯片供应产生瓶颈的主要原因。亚系外资法人分析,CoWoS 封装产能吃紧,关键原因在中介层供不应求,因为中介层硅穿孔制程复杂,且产能扩充需要更多高精度设备,但交期拉长,既有设备也需要定期清洗检查,硅通孔制程时间拉长,因此牵动 CoWoS 封装排程。
除了台积电,今年包括联电和日月光投控旗下硅品精密,也逐步扩充 CoWoS 产能。台积电在 4 月下旬北美技术论坛透露,正在开发重布线层(RDL)中介层的 CoWoS 解决方案,可容纳更多高带宽内存堆叠;联电在 7 月下旬法说会也表示,加速展开提供客户所需的硅中介层技术及产能。美系外资法人透露,台积电正将部分硅中介层(CoWoS-S)产能转移至有机中介层(CoWoS-R),以增加中介层供应。日月光投控在 7 月下旬法说会也表示,正与晶圆厂合作包括先进封装中介层元件;IC 设计服务厂创意去年 7 月指出,持续布局中介层布线专利,并支援台积电的硅中介层及有机中介层技术。
此外,英伟达GH100 还需要 HBM2E、HBM3 和 HBM3E 等高带宽内存。而英伟达需要获得足够数量的高带宽内存,虽然目前主要由SK海力士供应,但是随着需求的提升,预期可能需要从三星、SK 海力士和美光来同时采购。
最后,英伟达的服务器合作伙伴能够将基于 GH100 芯片打造加速卡产品装入到服务器,不但考验合作伙伴的产能,而且市场要一直保证足够的需求量。而一旦如果所有条件都成立,则 2024 年英伟达的业绩将有望更上一层楼。
编辑:芯智讯-林子