在近期于美国檀香山举行的2022年度VLSI 国际研讨会上,英特尔公布Intel 4制程的细节。英特尔表示,相较Intel 7,Intel 4 在相同功耗前提下提升20% 以上的性能,高性能元件库(library cell)密度也是Intel 4的2倍,同时还达成了两项关键目标:满足开发中产品需求,包括PC 客户端的Meteor Lake,并推动先进制程技术和模组,带领英特尔2025 年重回制程领先地位。
英特指出,Intel 4 于鳍片间距、接点间距及低层金属间距等关键尺寸(Critical Dimension)持续朝微缩前行,并导入设计技术协同最优化,进一步缩小单一元件尺寸。通过基于FinFET技术的材料与结构改良提升效能,Intel 4 单一N 型半导体或P 型半导体,鳍片数从Intel 7 高性能元件库的4 片降至3 片。综合上述技术,使Intel 4 大幅增加逻辑元件密度,并缩减路径延迟和功耗降低。
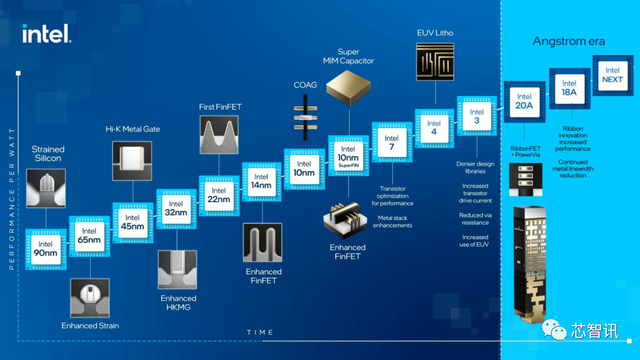
另外,Intel 7 还导入了自对准四重成像技术(Self-Aligned Quad Patterning,SAQP)和主动元件闸极上接点(Contact Over Active Gate,COAG)技术提升逻辑密度。自对准四重成像技术能通过单次光刻、两次沉积与蚀刻步骤,将晶圆光刻图案缩小了4 倍,且没有多次光刻层叠对准的问题。主动元件闸极接点则将闸极接点直接设在闸极上方,而非传统闸极一侧,提升元件密度。Intel 4 进一步加入网格布线方案(gridded layout scheme),简化并规律化电路布线,提升效能同时还改善生产良率。
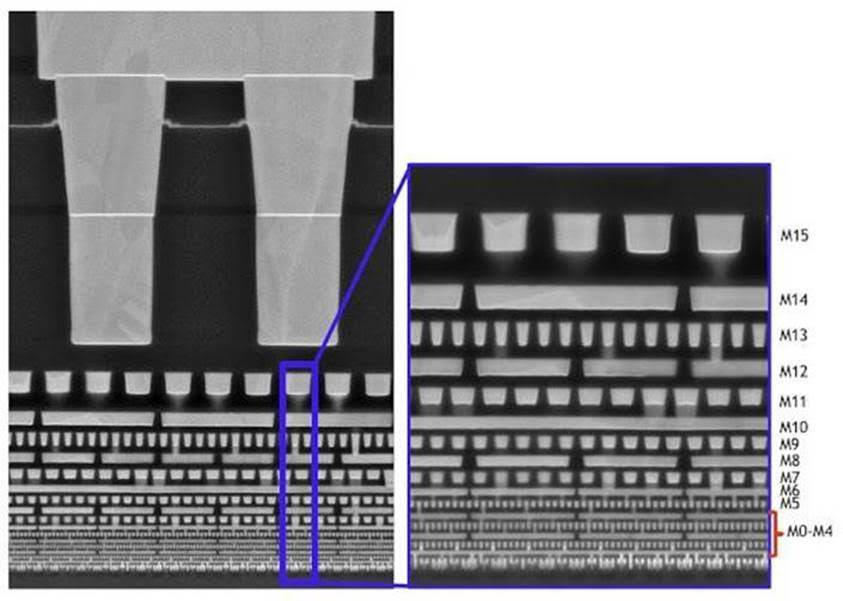
随着制程进一步微缩,晶体管上方金属导线、接点也随之缩小。导线电阻和线路直径呈现反比,该如何维持导线效能是需要克服的壁垒。Intel 4 采用新金属配方称为(Enhance Cu),使用铜为导线、接点主体,取代Intel 7 的钴,外层再用钴、钽包覆;此方案兼具铜的低电阻特性,并降低自由电子移动时撞击原子使移位,进而让电路失效的电迁移(electromigration)现象,为Intel 3 和未来制程打好基础。
最后,光罩图案成像至晶圆的最重要改变,可能是在广泛使用EUV 简化制程。英特尔不仅现有良好解决方案最关键层使用EUV,且Intel 4 较高互连层也使用了EUV,大幅减少光罩数量和制程步骤。降低制程复杂性,亦同步替未来制程节点建立技术领先地位及设备产能,英特尔将在这些制程更广泛使用EUV,并将导入全球第一款量产型高数值孔径(High-NA)EUV 系统。
编辑:芯智讯-林子