
当地时间1月24日,英特尔官方宣布,其位于美国新墨西哥州里奥兰乔(Rio Rancho)的尖端封装工厂 Fab 9 正式开业。这一里程碑是英特尔此前宣布的 35 亿美元投资的一部分,旨在升级其新墨西哥工厂,以制造先进的半导体封装技术,其中包括英特尔突破性的 3D 封装技术 Foveros,该技术为组合针对功耗、性能进行优化的多个芯片提供了灵活的选择和成本。

在9月19日的英特尔 ON 技术创新峰会上,英特尔公布了面向笔记本电脑产品的代号为Meteor Lake的英特尔酷睿Ultra处理器,并宣布该处理器将在今年12月14日正式推出。

12月5日消息,在IEDM 2022(2022 IEEE国际电子器件会议)上,英特尔发布了多项突破性研究成果,继续探索技术创新,以在未来十年内持续推进摩尔定律,最终实现在单个封装中集成一万亿个晶体管。

虽然在半导体先进制程工艺方面,近日三星成功抢先台积电量产了3nm GAA制程工艺,但是在2.5/3D先进封装技术方面,三星仍落后于英特尔和台积电。而为了缩短这方面的差距,三星也已经组建了新的半导体封装工作组发力先进封装技术。

当地时间6月16日,晶圆代工巨头台积电在美国加利福尼亚州圣克拉拉召开了2022年台积电技术研讨会,介绍了台积电的技术现状和即将推出的路线图,涵盖了工艺技术和先进封装开发的各个方面。在之前的报道《台积电2nm细节曝光:功耗降低30%!成熟制程产能2025年将提升50%》当中,我们有介绍关于制程工艺技术的部分。今天我们再来聊聊台积电的先进封装技术。

6月2日消息,半导体封测龙头日月光宣布,推出垂直互连整合封装解决方案——VIPack 先进封装平台。VIPack 是日月光扩展设计规则,并实现超高密度和高性能设计的下一世代3D 异质整合架构,此平台利用先进的重布线层(RDL) 制程、嵌入式整合以及2.5D/3D 封装技术,协助客户在单个封装中集成多个芯片来实现创新未来应用,目前该平台已经正式推向市场。

3月21日消息,由于3nm及更先进制程投资成本越来越高,为了继续推进芯片整体性能和成本并降低成本,2.5D/3D先进封装技术越来越受到产业界的青睐,并已进入高速成长期。根据市场研究机构Yole Developpement统计,英特尔及台积电去年在先进封装领域的资本支出居于领先地位,同时掌握了技术制定的话语权,日月光投控及三星则紧追在后,前四大厂厂商的资本支出合计占比高达85%。

日前,IPU公司Graphcore(拟未)宣布推出其全新称为Bow的IPU,以及计算刀片:Bow-Machine和计算系统Bow Pod系列。相比较搭载第二代IPU——Colossus Mk2 GC200的M2000而言,Bow Pod系列可以实现总体40%的性能提升,以及每瓦性能16%的提升。

6月2日,晶圆代工龙头台积电在台北举办2021 年技术论坛,这也是台积电连续第二年采用线上形式举行,共有超过5,000 位来自全球各地的客户与技术伙伴注册参与。在此次活动上,台积电分享了最新的技术发展,其包括针对下一代5G射频器件与WiFi 6/6e产品的N6RF 制程、针对最先进汽车应用的N5A 制程、以及3DFabric 系列先进封装与芯片堆叠技术的强化版。
据报道,全球最大半导体代工企业台积电正在与 Google 等美国客户共同测试、开发一种先进的“整合芯片”封装技术,并计划于 2022 年量产。
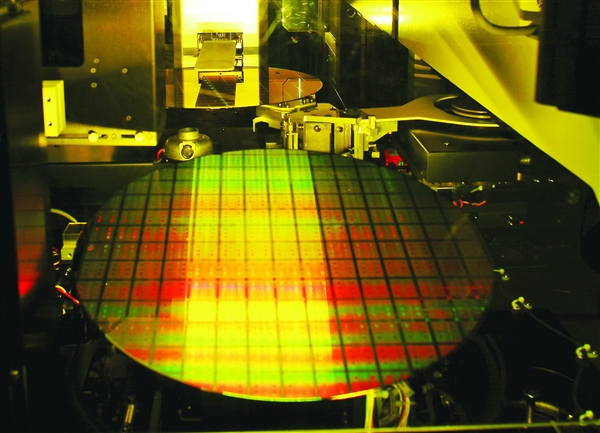
日前在台积电说法会上,联席CEO魏哲家又透露了台积电已经完成了全球首个3D IC封装,预计在2021年量产,据悉该技术主要面向未来的5nm工艺,最可能首发3D封装技术的还是其最大客户苹果公司。