
1月29日消息,据台媒报道,面板大厂群创的半导体业务已成功拿下了欧洲半导体大厂恩智浦(NXP)面板级扇出型封装(FOPLP)大单。恩智浦几乎包下群创相关所有产能,将在下半年量产出货。
据了解,群创布局面板级扇出型封装技术已有八年,这次夺下恩智浦大单,将让群创初期构建的Chip-First制程产能满载,今年准备启动第二期扩产计划,为2025年扩充产能投入量产做好准备。
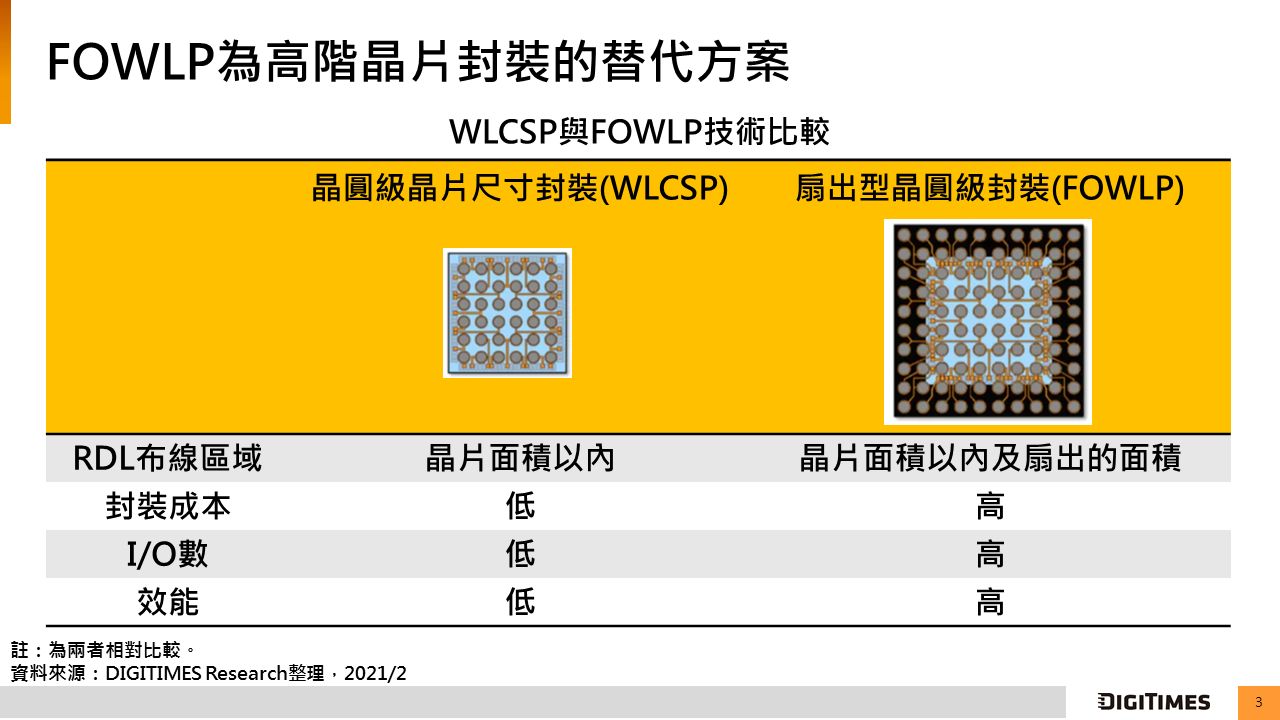
报道称,群创是以现有3.5代面板产线改造为生产面板级扇出型封装产品,相关折旧几乎都已告一段落,因此毛利率很好。这也是群创布局半导体封装的第一张订单,在电视面板报价回稳之际,为群创营运再新动能。
群创2023年7月在“2023国际半导体展”上召开记者会,宣布位于南科的一厂“起家厝”3.5代线已成功“华丽转身”,所产出的面板级扇出型封装技术,适用于要求可靠度、高功率输出的车用、功率芯片封装产品,已陆续送样客户验证中,2024年底有望量产,月产能可达1.5万片。
据悉,群创的面板级扇出型封装技术拥有效率与成本两大优势,并且具有高功率且轻薄短小的特色,成为让恩智浦下单的主要因素。群创原规划,面板级扇出型封装技术初期锁定车用与手机两大应用市场。
群创董事长洪进扬此前曾表示,群创的一厂为3.5代线旧面板厂,已经完成折旧摊提,生产制造的成本相对要低许多,采用面板级扇出型封装技术封装的芯片不仅整体成本可望下降,可靠度也有所提升,可望为先进封装提供新的技术路径。
群创总经理杨柱祥指出,面板级封装在布线上具有低电阻、减少芯片发热特性,最适合车用IC、高压IC等芯片应用,并瞄准DR-MOS三合一节能元件新应用。
洪进扬此前还曾透露,群创近年来在面板级扇出型封装技术投入的资本支出已达新台币20亿元,这相对于面板厂每股动辄新台币数百亿元的资本支出而言,属于“轻量级”的投资。群创初期在3.5代厂打造RDL-First以及Chip-First封装二类制程,前者主要供应通讯产品应用;后者则是针对车用的快充所需芯片的市场。
洪进扬说,群创第一期建置的Chip-First产能,虽然尚未量产,但已全数被客户预订一空。客户排队热况称得上是“超乎预期的热烈”,也是面板厂很久没有感受到的温暖。
不过,对于已拿下恩智浦大单的传闻,群创28日表示:“不对市场传闻与客户做评论。”
编辑:芯智讯-浪客剑






