8月7日消息,处理器大厂英特尔日前介绍了其PowerVia背面供电技术,并指出Intel 20A将是旗下首个采用PowerVia背面供电技术及RibbonFET全环绕栅极晶体管技术的节点制程,预计将于2024年上半年达到生产准备就绪的阶段,将应用于未来量产消费性的ARL处理器平台,而目前正在晶圆厂启动First Stepping的前期阶段。
英特尔指出,接下来的Intel 18A也正在进行内部和外部测试,有望在2024年下半年达成生产准备就绪。目前,Arm已经和英特尔代工服务(IFS)签署了有关多世代的先进系统芯片设计的协议,使芯片设计公司能够利用Intel 18A级点制程开发低功耗计算系统级芯片(SoC)。
值得注意的是,不久前,英特尔就已经宣布,将采用Intel 18A制程为瑞典电信设备商爱立信打造定制化5G系统级芯片。
说到英特尔开发PowerVia背面供电技术的背景,就不得不从芯片的发展来谈起。因为一直以来,芯片都是像披萨一样由下而上,层层制造的。芯片制造从最小的元件晶体管开始,然后逐步建立越来越小的线路层,用于连接晶体管和芯片的各个部分。这些线路被称为互连线,当中还包括给芯片供电的电源线。芯片完成后,把它翻转并封装起来。封装提供了与外部的接口,然后真正成为一个商用化的系统级芯片。
然而,这种方法遇到了各种问题。随着晶体管越来越小,密度越来越高,互连线和电源线共存的线路层变成了一个越来越混乱的网络,成为提升芯片整体性能的障碍。对此,曾参与开发PowerVia技术的英特尔技术开发副总裁Ben Sell就表示,这个问题之前不受重视,但现在产生了巨大的影响。原因是芯片中的功率和信号会衰减,需要变通的办法。

对此,英特尔和领先的芯片制造商都在努力研究背面供电技术,寻找将电源线迁移到芯片背面的方法,进一步使得芯片正面只需要专注于建晶体与元器件的互连。所以,在2023年VLSI研讨会上,英特尔展示了制造和测试其背面供电解决方案PowerVia的过程,并公布已经有良好性能的测试结果。
Ben Sell指出,告别披萨式的制造方式,芯片制造第一次关系到上下两个面。上面与过去芯片生产一样,而下面是PowerVia背面供电技术应用空间。首先在上面制造晶体管,然后添加互连层。但是,接下来就是一个有趣的阶段,那就是翻转晶圆并进行打磨,露出上面连接电源线的底层。这时,打磨后,让原本厚度以微米计算的芯片底层,留下了非常直接的路径给PowerVia背面供电技术来使用。
Ben Sell证实,这种方法的好处是多方面的,超过了新制程技术更高的复杂性所带来的不利影响。例如,电源线可能占据芯片上面空间的20%。因此,随着这些电源线的消失,互连层可以宽松一些。而为了证明这种方法,英特尔团队制作了称为Blue Sky Creek的测试芯片,该芯片采用英特尔即将推出的PC处理器Meteor Lake中的P-Core性能核心,其测试芯片证明PowerVia解决了披萨式旧方法造成的问题。也就是电源线和互连线可以分离开来,并做得线径更大,以同时改善供电和信号传输。
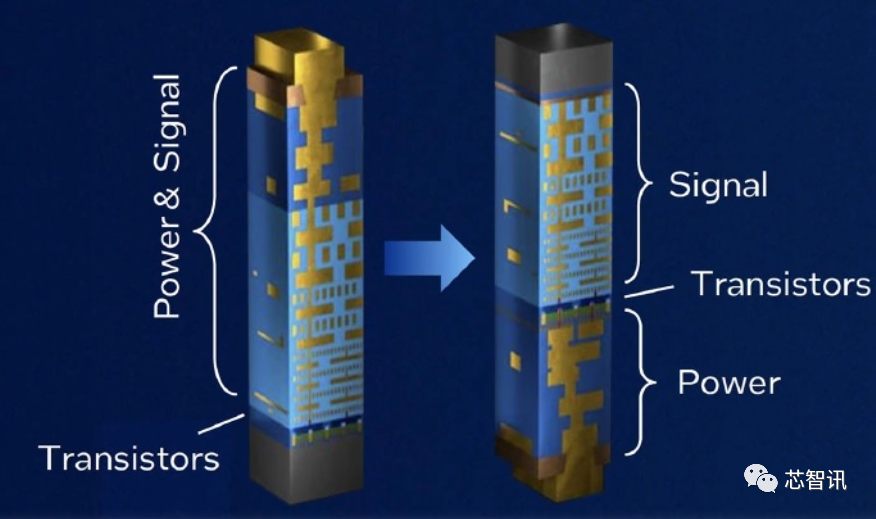
这结果对普通电脑用户来说,代表着降低能效和提高速度。在降低功耗的情况下能更快的完成工作,再次延续摩尔定律的发展。Ben Sell强调,使用PowerVia技术的英特尔性能核心达到了6%的频率提升和超过90%的标准单元利用率。这样的结果对于仅仅是将电源线迁移来说,这是庞大的频率提升。
目前,测试芯片是采用第一层和最底层晶体管。未来,在许多晶体管被夹在芯片中间的情况下,还有许多新技术都必须再重新开发。另外,为了PowerVia背后供电技术的开发,英特尔采用了前一代Intel 4节点制程,应用经过充分验证的晶体管,并采用了为Intel 20A规划的电源和互连设计,以准备在Intel 20A制程技术量产时使用。
编辑:芯智讯-林子







