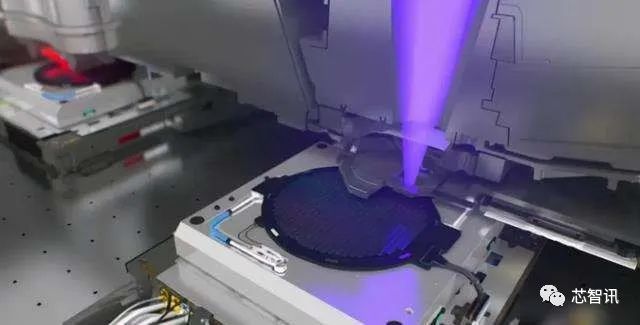
11月19日消息,在华为被美国限制芯片制造之后,业内就一直有传闻称华为在自研“卡脖子”的光刻机,希望打造去美化产线,以推动自研芯片的恢复生产。近日,华为申请的一项名为“反射镜、光刻装置及控制方法”的EUV光刻相关专利被曝光,这似乎也侧面印证了华为在研发光刻机的传闻。
根据国家知识产权局公布的信息显示,这项名为《反射镜、光刻装置及其控制方法》的专利,能够解决相干光因形成固定的干涉图样而无法匀光的问题,在极紫外光的光刻装置基础上进行了优化,进而达到匀光的目的。

我们都知道,在集成电路制造中,光刻覆盖了微纳图形的转移、加工和形成环节,决定着集成电路晶圆上电路的特征尺寸和芯片内晶体管的数量,是集成电路制造的关键技术之一。但是随着半导体工艺向7nm及以下节点的推进,极紫外(extreme ultraviolet,EUV)光刻成为首选的光刻技术。
目前ASML是全球最大的光刻机厂商,同时也是全球唯一的EUV光刻机厂商。但是在美国的阻挠之下,近年来荷兰对于EUV光刻一直限制向中国大陆出口。因此,中国想要在EUV光刻技术上进行突破,那么就只能靠自己。
根据华为的这项专利说明显示,相关技术的EUV光刻机中采用强相干光源在进行光刻时,相干光经照明系统分割成的多个子光束具有固定的相位关系,当这些子光束投射在掩膜版上叠加时会形成固定的干涉图样,出现有明暗变化、光强不均匀的问题,因此,必须先进行去相干处理(或者采用避免相干影响),达到匀光效果,以保证光刻工艺的正常进行。
华为的这项专利发明的核心内容,是提供了一种反射镜、光刻装置及其控制方法,能够解决相干光因形成固定的干涉图样而无法匀光的问题。
装置结构与关键组成
该专利提供一种光刻装置,该光刻装置通过不断改变相干光形成的干涉图样,使得照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。
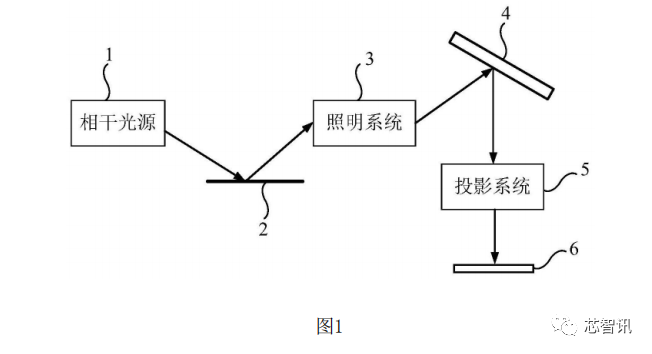
△如图1所示,该光刻装置包括相干光源 1、反射镜 2 (也可以称为去相干镜)、照明系统 3。其中,反射镜 2 可以进行旋转;例如,可以在光刻装置中设置旋转装置,反射镜 2 能够在旋转装置的带动下发生旋转。在该光刻装置中,相干光源 1 发出的光线经旋转的反射镜 2 的反射后,通过照明系统 3 分割为多个子光束并投射至掩膜版 4 上,以进行光刻。
在光刻装置中,上述照明系统 3 作为重要组成部分,其主要作用是提供高均匀性照明 (匀光)、控制曝光剂量和实现离轴照明等,以提高光刻分辨率和增大焦深。
照明系统 3 的匀光功能可以是通过科勒照明结构实现的。
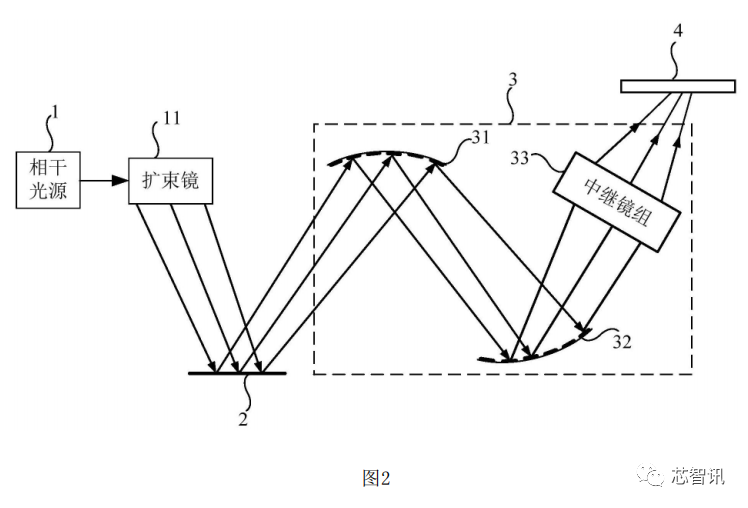
如图2所示,该照明系统 3 包括视场复眼镜 31 (field flyeye mirror,FFM)、光阑复眼镜 32 (diaphragm flyeye mirror,PFM)、中继镜组 33;其中,中继镜组 33 通常可以包括两个或者两个以上的中继镜。照明系统 3 通过视场复眼镜 31 将来自相干光源 1 的光束分割成多个子光束,每个子光束再经光阑复眼镜 32 进行照射方向和视场形状的调整,并通过中继镜组 33 进行视场大小和 / 或形状调整后,投射到掩膜版 4 的照明区域。
通过在相干光源 1 与照明系统 3 之间的光路上设置反射镜 2,在此情况下,相干光源 1 发出的光线经旋转的反射镜 2 反射后相位不断发生变化,这样一来,在经反射镜 2 反射后的光线通过照明系统 3 分割为多个子光束并投射至掩膜版 4 上时,形成在掩膜版 4 的照明区域的干涉图样不断变化,从而使得照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。
具体发明内容介绍
具体来说,该申请实施例提供一种反射镜,该反射镜的反射面包括多个微反射面;多个微反射面中包括第一微反射面以及与第一微反射面相邻的第二微反射面;第一微反射面与第二微反射面之间具有高度差Δh,且该高度差Δh位于(0,kλ]的区间内;其中,λ为极紫外光的波长;k为大于或等于1的正整数。
在该反射镜中,通过设置反射面内相邻的两个微反射面之间具有高度差,从而使得相干光经旋转的反射镜进行反射后,相位发生随机化;这样一来,在将该反射镜应用至光刻装置时,通过将该反射镜设置在相干光源与照明系统之间的光路,能够使得相干光源发出的光束经反射镜反射后,通过照明系统分割为多个子光束投射至掩膜版形成干涉图样,并随着反射镜的不断旋转,使得进入的照明系统的多个子光束的相位实现随机化,从而使得照明视场形成的干涉图样不断变化,这样一来,只要曝光时间内干涉图样变化速率足够快,即可使得照明视场在曝光时间内的累积光强均匀化,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。
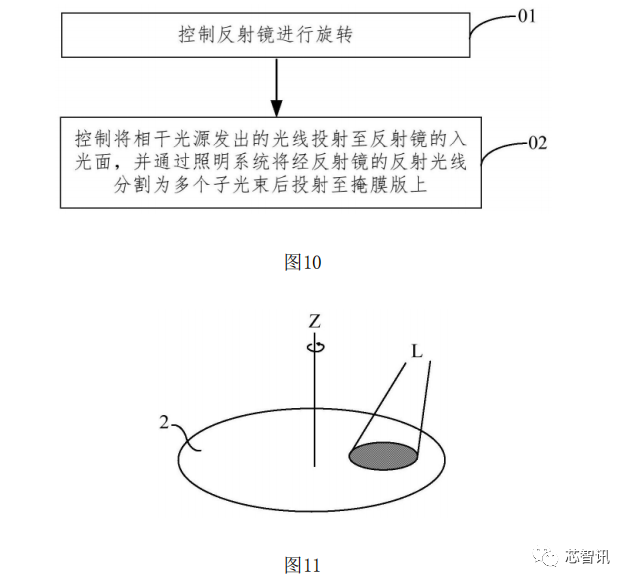
△图11为本申请实施例提供的一种光刻装置控制过程中的示意图。
在一些可能实现的方式中,前述k为小于或等于300的正整数(也即k为不超过300的正整数);以减小光线在微反射面的边缘位置(也即形成高度差的位置)被遮挡而造成光能损失,提高光的利用率。
在一些可能实现的方式中,上述极紫外光的波长为5nm~30nm,也即λ在5nm~30nm的范围内。
在一些可能实现的方式中,反射镜的反射面内包括多组第一微反射面和第二微反射面,且所有的第一微反射面和第二微反射面之间形成的高度差的绝对值均位于(0,kλ]的区间内;以保证经反射镜反射的光线投射至掩膜版的照明视场形成的干涉图样发生明显的变化,提高照明视场在曝光时间内的光强均匀性。
在一些可能实现的方式中,每一微反射面的面积相等;以提高经反射镜的反射光线的相位随机化,保证经反射镜反射的光线投射至掩膜版的照明视场形成的干涉图样发生明显的变化,提高照明视场在曝光时间内的光强均匀性。
在一些可能实现的方式中,反射镜为圆形;反射镜按照圆心为极坐标的极点,沿极径划分为位于中心的圆形反射单元以及位于所述圆形反射单元外侧的M-1个圆环形反射单元,圆形反射单元和每一圆环形反射单元沿极角均划分为多个微反射面;也即该反射镜沿极径划分为M个反射单元,每一反射单元沿极角划分为多个微反射面;其中,M为正整数。

△例如,如图3所示,在一些可能实现的方式中,可以按照圆形反射镜2的圆心为极坐标的极点,沿极径和极角方向横纵划分为多个不规则的微反射面a。
在一些可能实现的方式中,上述圆形反射单元和每一圆环形反射单元沿极角等分为N个所述微反射面;也即每一反射单元沿极角等分为N个微反射面;其中,N为正整数;从而形成M×N个微反射面。
在一些可能实现的方式中,上述圆形反射单元和M-1个圆环形反射单元的半径相等,也即M个反射单元的的半径相等。
在一些可能实现的方式中,圆形反射单元和M-1个圆环形反射单元中任意相邻的两个反射单元分别为第一反射单元和第二反射单元;其中,第二反射单元到极点的距离大于第一反射单元到极点的距离,且第二反射单元的半径小于第一反射单元的半径;也即沿远离极点的方向上,M个反射单元的半径依次减小;这样一来,通过具体设置每一反射单元的半径,从而能够使得该反射镜中每一个微反射面的面积相同或者近似相同,进而能够改善反射镜对反射光线的随机相位化。
在一些可能实现的方式中,圆形反射单元和M-1个圆环形反射单元中任意相邻的两个反射单元分别为第三反射单元和第四反射单元;第三反射单元到极点的距离小于第四反射单元到极点的距离,且第三反射单元沿极角划分的微反射面的数量小于第四反射单元沿极角划分的微反射面的数量;也即沿远离极点的方向上,M个反射单元沿极角划分的微反射面的数量依次增加;这样一来,通过具体设置每一反射单元沿极角等分的微反射面的数量(也可以说,分别设置每一反射单元的等分单位角度),从而能够使得该反射镜中每一个微反射面的面积相同或者近似相同,进而能够改善反射镜对反射光线的随机相位化。
在一些可能实现的方式中,微反射面为矩形,且多个微反射面呈网状分布。

△如图5所示,在一些可能实现的方式中,可以将反射镜2划分为呈网状分布的多个矩形微反射面a。
本申请实施例提供一种光刻装置,包括相干光源、照明系统以及如前述任一种可能实现的方式中提供的反射镜;且该反射镜可旋转;相干光源发出的光线经旋转的反射镜的反射后,通过照明系统分割为多个子光束并投射至掩膜版上。
在此情况下,相干光源发出的光束经反射镜反射后,通过照明系统分割为多个子光束投射至掩膜版,并在掩膜版的照明视场形成干涉图样,随着反射镜的不断旋转,能够使得进入的照明系统的多个子光束的相位实现随机化,从而使得照明视场形成的干涉图样不断变化,这样一来,只要曝光时间内干涉图样变化速率足够快,即可使得照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的。
在一些可能实现的方式中,相干光源发出的光线为波长5nm~30nm的极紫外光,以“刻”出更精细的图形,提高单位面积上器件密度并降低器件功耗。
在一些可能实现的方式中,相干光源为自由电子激光(freeelectron laser,FEL)光源;该FEL光源利用自由电子和光辐射的相互作用,将电子能量转送给光辐射使得辐射强度增大从而获得激光输出,进而使得FEL极紫外光具有波长可调、高准直度、高稳定性、低能散和高亮度等优势。
本申请实施例还提供一种如前述任一种可能实现方式中提供的光刻装置的控制方法,该控制方法包括:控制反射镜进行旋转;控制将相干光源发出的光线投射至反射镜的反射面,并通过照明系统将经反射镜的反射光线分割为多个子光束后投射至掩膜版上。
在此情况下,通过控制相干光源发出的光线经旋转的反射镜反射,使得光线的相位不断发生变化,从而能够使得通过照明系统后相干光形成在掩膜版的照明区域的干涉图案不断发生变化,使得掩膜版的照明视场在曝光时间内的累积光强均匀化,从而达到匀光的目的,进而也就解决了相关技术中因相干光形成固定的干涉图样而无法匀光的问题。
在一些可能实现的方式中,控制将相干光源发出的光线投射至反射镜的反射面包括:控制将相干光源发出的光线投射至反射镜的反射面偏离中心的区域。在此情况下,通过增加反射镜的口径,并控制入射光束投射至反射镜偏离中心的部分,能够使得中心部分光强较强部分的子光束的相位得到有效的随机化,进而提升反射镜的去相干性能。
小结:
正如最早传出华为将自研光刻机传闻时芯智讯给出的判断一样,目前华为即使有在自研光刻机,也应该依然是在进行相关关键技术攻关的早期阶段,要想成功自研出可用于先进制程的光刻机还为时尚早,更何况是更先进的EUV光刻机。
要知道ASML的EUV光刻机则拥有超过10万个零件,极为复杂,并且这些零件几乎都是定制,90%零件都采用的是世界上最先进技术,甚至一些接口都要工程师用高精度机械进行打磨,尺寸调整次数更可能高达百万次以上。
资料显示,在AMSL的EUV光刻机的10万个零配件当中,其中有8万多个精密零件来自全球40多个国家,而其核心零部件则主要来自于欧美日韩以及中国台湾。比如,ASML的光刻机的光学镜头来自德国蔡司,光源技术来自美国的Cymer(已被ASML收购)。
显然,即便是对于ASML来说,其EUV光刻机的很多的关键零部件也是由全球众多不同的厂商所供应,并不是其仅凭一己之力能够实现的。同样对于华为来说,攻克一些EUV领域的关键技术是有可能实现的,但是要想造出一台可商用的EUV光刻机,那么需要的是整个国内或者非美系光刻机供应链厂商的共同努力和共同突破。
然而目前国产的可以用于28nm及以下先进制程的DUV光刻机都还尚未完成交付,更何况是技术和供应链封锁更为严重的EUV光刻机,这恐还需要超过10年以上的时间才有希望。
编辑:芯智讯-浪客剑