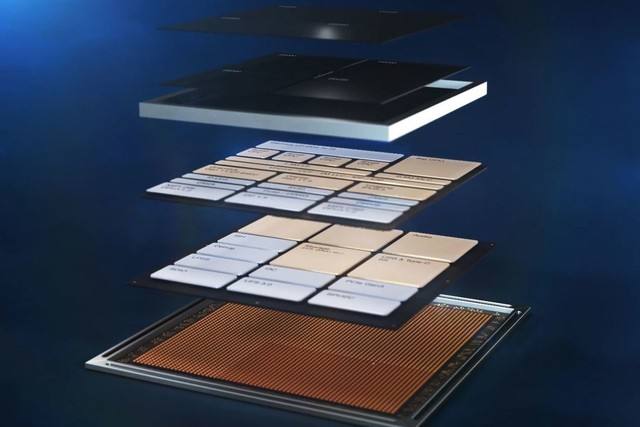
10 月 8 日,中段硅片制造和三维多芯片集成加工企业盛合晶微半导体有限公司(SJ Semiconductor Co.)宣布,与系列投资人签署了总额为 3 亿美元的 C 轮增资协议,并已实现美元出资到位。参与增资的投资人包括光控华登、建信股权、建信信托、国方资本、碧桂园创投、华泰国际、金浦国调等,既有投资人元禾厚望、中金资本、元禾璞华也参与了本次增资。增资完成后,公司的总融资额将达到 6.3 亿美元,投后估值超过 10 亿美元。
盛合晶微原名中芯长电半导体有限公司,是中国大陆第一家致力于 12 英寸中段凸块和硅片级先进封装的企业,也是大陆最早宣布以 3DIC 多芯片集成封装为发展方向的企业。本次增资是 2021 年 6 月股权结构调整后,公司首次独立开展的股权融资。
“感谢新老投资人对公司的信任和支持,本次增资将使公司的投资人组合更加多元,带入更广泛的资源。增资协议的签署和美元出资的迅速到账,将确保公司按照业务规划继续快速发展。公司将继续坚持高质量运营,适时扩大产能规模,做客户信任和优选的一流硅片级先进封装和测试服务提供商。” 盛合晶微董事长兼首席执行官崔东先生表示,“本次具规模的股权融资,还将确保公司能够持续研发创新,加快有自主知识产权的三维多芯片集成封装技术平台的量产进度,满足 5G、高性能运算、高端消费电子等新兴电子市场对先进封装技术和方案的需求。”
盛合晶微成立七年来,坚持高起点、大规模、快速度建设,2016 年即开始提供与 28 纳米及 14 纳米智能手机 AP 芯片配套的高密度凸块加工和测试服务,是大陆第一家提供高端 DRAM 芯片和 12 英寸电源管理芯片凸块加工服务的企业,也是目前大规模提供 12 英寸硅片级尺寸封装(WLCSP)的领先企业。精微至广、持续创新,公司开发的 SmartPoser 三维多芯片集成加工技术平台,在 5G 毫米波天线封装领域展现了性能和制造方面的优势,正在为越来越多的新兴应用领域所认可。
公开资料显示,盛合晶微于2014年8月注册成立,是全球首家采用集成电路前段芯片制造体系和标准,采用独立专业代工模式服务全球客户的中段硅片制造企业。以先进的12英寸凸块和再布线加工起步,盛合晶微致力于提供世界一流的中段硅片制造和测试服务,并进一步发展先进的三维系统集成芯片业务。
盛合晶微总部位于中国江阴高新技术产业开发区,在上海和美国硅谷设有分支机构,服务于国内外先进的芯片设计企业。







