7月6日消息,据韩国媒体 BusinessKorea 的报导,日前在韩国首尔举办的 2023 年度“三星晶圆代工论坛”上,三星电子代工业务总裁崔世英介绍了三星的晶圆代工路线策略。
崔世英表示,三星计划到 2025 年将 GAA 制程技术制造的芯片应用扩展到 3D 封装上。原因是制程微缩在降低成本和缩小芯片面积方面存在限制,因此三星正在多样化其后段先进技术。
事实上,当前产业界尚未将 GAA 制程技术与 3D 先进封装技术互相结合,这主要是因为这两种制程技术的复杂度都很高。其中,GAA 制程技术取代了传统的 FinFET 制程技术,最大化了数据传输路径的面积,同时减小了芯片的尺寸。至于3D 先进封装则是一种整合技术,可以使不同的小芯片堆叠在一起,并在一个封装内,可以像单个芯片一样发挥作用。这些技术在当前制程微缩逐步达到极限的情况下,显得尤为重要。目前,英特尔和台积电等竞争对手都正在先进封装领域激烈竞争,以增强这些技术的商用化。
报道指出,三星于 2020 年首次推出了支持 7nm EUV 制程芯片的 3D 先进封装技术 X-Cube。2022 年,三星还全球率先将 3nm GAA制程技术导入量产。当时,三星在半导体业务部门内组建了先进封装 (AVP) 业务团队,加速下一代半导体后段制程的研发。三星预计到 2027 年,将如期量产 1.4nm先进制程。
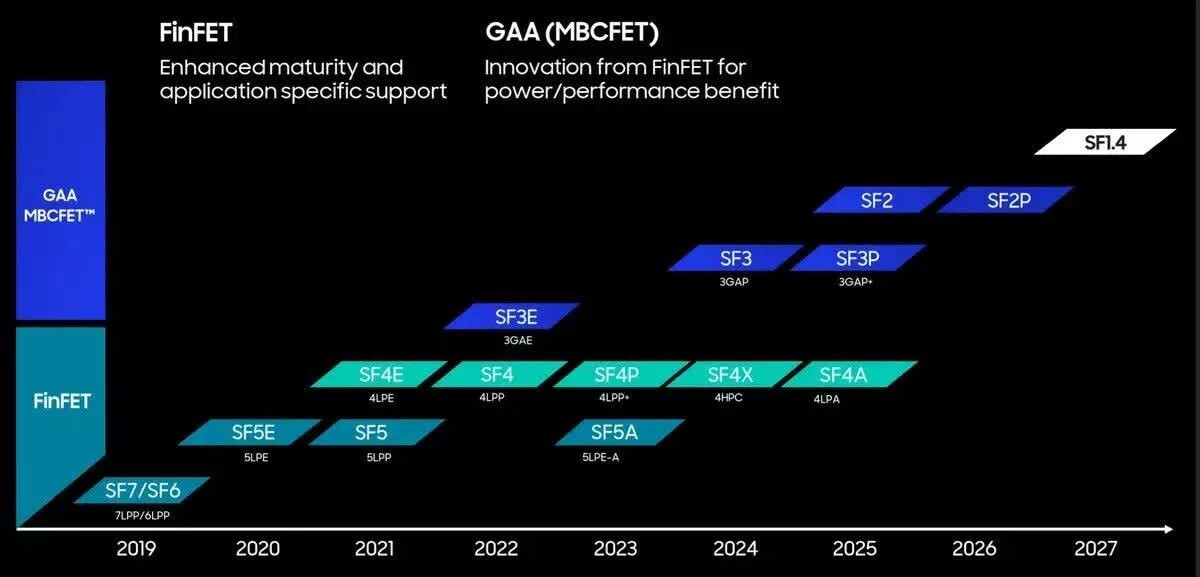
不过,在2023 年第一季的全球晶圆代工市场占有率上,三星与台积电的差距较上一季有所扩大。台积电占比为 60.1%,三星电子占比则只有 12.4%。三星此前多次强调,与台积电在3nm制程采用传统 FinFET 技术不同,三星电子从3nm开始就采用了更先进的GAA 技术,所以有信心在之后GAA技术的竞赛中进一步领先台积电。
事实上,韩国的无晶圆厂IC 设计和系统半导体的基础很脆弱。根据韩国半导体产业协会的统计,韩国系统半导体的全球市场占比仅为 3%,无晶圆厂IC设计公司全球占比更低,仅略高于1%。而且,今年一季度全球排名前十大的无晶圆厂IC设计公司中,有6家是美国公司,3家来自中国台湾。其中,中国台湾大大小小的无晶圆厂 IC 设计公司都在与台积电合作,一起创建系统半导体生态系统,也创造了台积电的强大市场竞争力。
相比之下,三星晶圆代工 90% 以上的客户来自于自己的系统 LSI 业务,以及高通和英伟达。这代表三星的晶圆代工很难与韩国本土的潜在客户一起成长。因此,为了强化三星晶圆代工业务的成长,三星在论坛上还宣布了发展本土系统半导体研发生态系统的计划。其中,三星将于2024年扩展其多项目晶圆 (MPW) 服务,该服务目标是成为人工智能和高效能运算 (HPC) 的关键推动者,预计采用4nm制程来服务客户,期望在 2025 年将 MPW 服务总数量提升10% 以上,以带动整体韩国硅统半导体产业的发展。
编辑:芯智讯-林子