近日,日本半导体设备大厂Disco公司成功开发出了一款新型SiC晶圆研磨设备DFG8541,可以加工最大尺寸为8英寸的硅和SiC晶圆,并将SiC晶圆的研磨速度提升至原来的10倍,极大地提高了生产效率。由于SiC晶圆的硬度极高,加工难度较大,这一技术突破对于推动SiC功率半导体的规模化生产具有重要意义。

8月1日消息,据日经新闻报道,日本半导体设备厂商Disco公司的一位高管透露,该公司希望在印度建立一个中心,为客户提供支持,并作为面向印度新兴半导体产业的营销基地。

4月20日消息,据日本媒体Newswitch报道,由于电动汽车所需的功率半导体需求持续增长,带动对于晶圆切割设备需求强劲,晶圆切割机大厂DISCO目前现有工厂产能持续全开,并计划在未来十年内将产能扩大到目前的3倍。

4月11日下午,在光力科技2022年度业绩说明会上,光力科技董事长、总经理赵彤宇表示,通过并购世界领先半导体设备及高端零部件企业,公司构建了半导体封测装备业务板块完整的技术与产品布局,奠定了公司在封测装备领域的技术领先优势,成为既有封测装备、又有空气主轴等核心零部件与刀片耗材的企业。公司将沿着既定的发展战略,迅速做强做大。

1月18日消息,据日本媒体Newswitch近日报导,晶圆切割设备大厂DISCO社长关家一马近日在接受日刊《工业新闻》专访表示,计划将切割/研磨芯片、电子零件材料的制造设备产能提高约四成,考虑在2025年度于日本长野县兴建新工厂。

9月29日消息,中国长城今天通过公众号宣布,在晶圆切割技术方面取得重大突破。其旗下郑州轨道交通信息技术研究院联合河南通用智能装备有限公司,仅用了一年时间,便完成了半导体激光隐形晶圆切割设备的技术迭代,分辨率由100nm提升至50nm,达到行业内最高精度,实现了晶圆背切加工的功能。与此同时,持续优化工艺,在原有切割硅材料的技术基础上,实现了加工CIS、RFID、碳化硅、氮化镓等材料的技术突破,对进一步提高我国智能装备制造能力具有里程碑式的意义。

近日,据日经新闻报导称,半导体厂商为了增产、扩大设备投资,也让制造设备需求当前有望持续维持高水准,日本晶圆切割机大厂Disco为了增产,正加快脚步扩增位于广岛县吴市和长野县茅野市工厂的产能,工厂产能利用率自2020年来就持续超过100%。
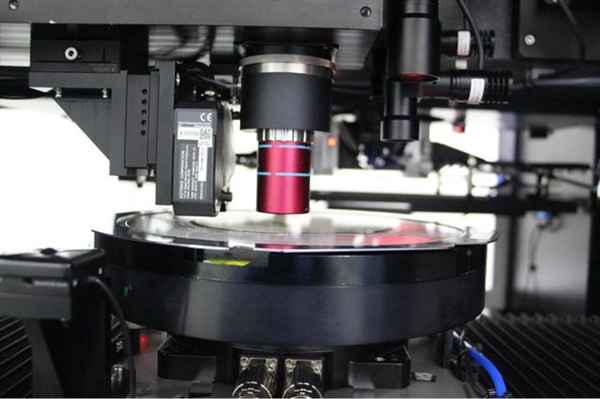
5月19日消息,近日,中国长城科技集团官方宣布,旗下郑州轨道交通信息技术研究院、河南通用智能装备有限公司,历时一年联合攻关,我国第一台半导体激光隐形晶圆切割机已于5月8日研制成功,填补国内空白,并实现了最佳光波和切割工艺,在关键性能参数上处于国际领先水平。